因为专业
所以领先
柔性电子中超薄硅基芯片封装技术的最新进展主要体现在材料创新、工艺优化、集成度提升等方面,以下从核心方向进行总结:
超薄基底材料突破
硅基芯片厚度已降至10微米以下,通过引入聚酰亚胺(PI)、石墨烯等柔性基底材料,结合二维材料(如MoS₂)的机械延展性,实现了芯片在弯曲半径≤5mm时的稳定性能。
示例:浙江晶引电子采用8微米级单面COF基板,通过化学蚀刻实现8μm线宽/线距,显著提升芯片电路密度。
高导热封装材料应用
为解决柔性基底散热难题,新型封装材料如纳米银胶、液态金属被集成到硅基芯片表面,导热系数提升至传统材料的3倍以上,有效降低工作温度30%以上。
超薄芯片减薄工艺
采用激光剥离(Laser Lift-Off)和化学机械抛光(CMP)技术,实现硅片减薄至5-20μm的同时保持良率>95%。
案例:宇凡微研发的SOT23-10封装,体积比传统MSOP10缩小46%,成本降低30%,适用于可穿戴设备的高密度集成。
卷对卷(R2R)工艺成熟
通过连续卷材加工技术,实现超薄芯片的大规模生产。例如,晶引电子的COF产线采用R2R设备,涨缩控制精度达万分之三,良率提升至99.9%。
异质集成技术
将硅基芯片与柔性传感器、RF元件通过3D堆叠封装,如甬矽电子的DiFEM模组封装,集成SAW滤波器和射频开关,厚度≤0.3mm,性能比传统方案提升20%。
机械稳定性优化
采用选择性空腔封装技术(如晶引电子的COF载带)和应力缓冲层设计,使芯片在10万次弯折后性能衰减<5%。
环境防护技术
新型密封胶(如聚对二甲苯涂层)可阻挡水氧渗透率<10⁻⁶ g/m²/day,延长柔性芯片在潮湿环境中的寿命至5年以上。
测试标准建立
通过JEDEC标准下的TCT(温度循环)、UHAST(高压加速寿命)等测试,确保封装产品符合工业级可靠性要求。
医疗健康:超薄硅基芯片用于植入式生物传感器(如血糖监测贴片),厚度<50μm,实现无创实时监测。
柔性显示:京东方等企业将超薄驱动IC封装至OLED面板,弯曲半径达3mm,支持可折叠屏幕量产。
物联网感知:集成环境传感器的柔性模组已用于智能农业监测,功耗降低40%,适应户外极端温湿度。
玻璃基板封装:如中国研发的第三代玻璃穿孔技术,在指甲盖大小基板上实现百万级微孔互联,成本下降50%。
智能封装:嵌入AI算法的自修复材料,可动态调整封装结构以适应形变。

FPC柔性电路板清洗:
柔性电路板上存在多种多样的污染物,能够归成离子型与非离子型这两大类。离子型污染物在接触到环境中的湿气后,在通电时会发生电化学迁移,形成树枝状的结构体,导致出现低电阻通路,使柔性电路板的功能受损。非离子型污染物能够穿透PCB的绝缘层,在PCB板表层下产生枝晶。除了离子型和非离子型污染物之外,还有粒状污染物,像焊料球、焊料槽内的浮点、灰尘以及尘埃等,这些污染物会引发焊点质量下降、焊接时焊点拉尖、产生气孔、短路等各种不良现象。
一般来说,人们觉得清洗表面贴装组件相当困难,这是因为有时表面贴装元件和柔性电路板之间的托高高度很低,形成了极其微小的间隙,有可能残留助焊剂,致使在清洗过程中难以将助焊剂去除。其实,如果在选择清洗工艺和设备时加以留意,并且让焊接和清洁工艺得到恰当的控制,那么清洗表面贴装组件就不应存在问题,即便是使用了具有侵蚀性的助焊剂。然而必须要强调的是,在使用侵蚀性水溶性助焊剂时,良好的工艺控制是必不可少的。
鉴于柔性电路板电子制程精密焊后清洗的不同需求,合明科技在水基清洗领域拥有颇为丰富的经验,针对具有低表面张力、低离子残留、需配合不同清洗工艺使用的情况,自主研研发出了相对完整的水基系列产品,精细化地对应涵盖了从半导体封装到PCBA组件终端,其中包含水基清洗剂和半水基清洗剂,碱性水基清洗剂以及中性水基清洗剂等。具体体现为,在同等清洗力的条件下,合明科技的兼容性更为优良,兼容的材料更为广泛;在同等兼容性的前提下,合明科技的清洗剂可清洗的锡膏种类更多(经过测试的锡膏品牌有ALPHA、SMIC、INDIUM、SUPER-FLEX、URA、TONGFANG、JISSYU、HANDA、OFT、WTO等;经过测试的焊料合金包括SAC305、SAC307、6337、925等不同成分),清洗的速度更快,离子残留更低、干净程度更好。


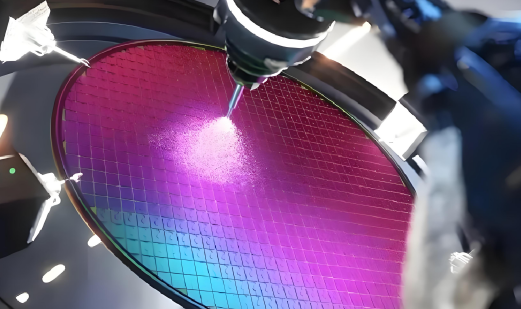


![[x]](/template/default/picture/closeimgfz1.svg)